
Elipsometrie spectroscopica:
Teorie si fundamente
Partea 1: Teorie & Fundamente
§ Ce este elipsometria?
§ Lumina si polarizare
§ Masuratori elipsometrice
§ Interactia luminii cu materia
§ Constante optice
Partea 2: Date experimentale si aplicatii
§ Ce poate masura elipsometria?
§ Modele optice si de regresie
§Grosime, constante optice
§ Rugozitate
§ Constante optice
§ Anizotropia
Part 3: Solutii elipsometrice
§ Instrumente liniare si accesorii
§ Software-ul de pachete si capabilitati
Partea 1:Teorie si fundamente
Ce este elipsometria?
§ Elipsometria este o metode optica, bazata pe schimbarea starii de polarizare atunci cand lumina se reflecta pe o suprafata.

Planul undelor electromagnetice
§ Cu ajutorul ecuatiei lui Maxwell putem descrie o unda de plan.

Lumina liniar polarizata
Ortogonal EX & EY
Undele sunt in acceasi faza
Rezulta : unde liniar polarizate
- "planul vibratiei" depinde de amplitudinea relativa a EX & EY

Lumina circular polarizata ????
Ortogonal EX & EY:
§ 90° in afara fazei & amplitudini egale
§ Rezulta : unde circular polarizate

Lumina eliptic polarizata
Ortogonal EX & EY:
§ Faze si amplitudini arbitrare
§ Rezulta : unde eliptic polarizate
- cele liniare si circulare sunt subseturi de polarizare eliptica
- Cele mai generale descrieri ale starii de polarizare

Masuratori elipsometrice
§ Elipsometria masoara schimbarea polarizarii luminii reflectate.
§Folosim sistemul de coordonate p-(paralel) si s-(perpendicular,din cuvantul german senkrecht), relativ pentru proba planului.
§ Raportul p/s este cuantificat de parametrii Y si D

Definitia datelor elipsometrice
§Definit ca raportul de reflectivitate al p/s
-![]() si
si ![]() sunt coeficienti complecsi de reflectie ai lui
Fresnel.
sunt coeficienti complecsi de reflectie ai lui
Fresnel.
Y (Psi) Amplitudinea raportului
D (Delta) Faza raportului
r (ro) Reflectivitatea complexa a raportului.

Intensitate vs. Polarizare
§ Intensitate = "Marimea" campului electric. I~E2
§ Polarizarea = "Forma" campului electric.

Avantajele elipsometriei
§ Repetabil & exact:
- auto-refeinta (experiment cu o singura radiatie) masurarea raportului pentru axele ortogonale Ep/Es
Astfel, problema se reduce la:
. Sursa de fluctuatie
. Mici probe suprapuse peste radiatia de lumina
§ Sensebil:
- Faza termenului D este foarte sensibila la grosimea peliculei
§ Masurarea a doi parametrii
Elipsometrie vs. Reflectrometrie
§ Faza de informatii da elipsometriei sensibilitate mai mare la pelicule foarte fine.

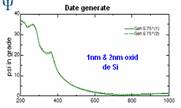

Cum functioneaza elipsometria
§ Fiecare elipsometru contine o sursa de lumina si detector, generator de polarizare si analizator.
§ Are nevoie deasemenea de selectarea lungimii de unda.

Elemente optice comune
§ Polarizorul: trecerea luminii liniar polarizata.
§ Compensatorul: Retine o orientare cu 90° pentru a transforma lumina liniar polarizata in lumina circular polarizata.

Configuratia elipsometrului

Modul de operare a analizatorului rotativ

§ 100% semnal sinusoidal de doua ori de la un analizator rotativ, de frecventa
§ lumina se stinge in totalitate cand analizatorul se incruciseaza cu radiatia de intrare liniar polarizata
§ semnalul DC constant, la fel ca si radiatia circular polarizata, are mereu componente egale prin analizatorul rotativ, lipsit de orientare.
Cum masoara RAE parametrii Y si D

Sensibilitatea elipsometrului RAE
§ Inversand ecuatia obtinem:


§ Sursele de zgomot arata diferentele:
- Zgomotul este minimalizat atunci cand y = P (P este azimutul polarizat de intrare)
- Zgomotul in delta devine mai mare cand: D = 0 sau D
§ Doar sensibilitatea pentru cos(D) nu poate determina"generozitatea" lui D.
De ce un analizator rotativ?
§ Avantaje:
- Un model optic simplu( doar doi polarizatori)
- Nu depinde de lungimea de unda: proba este singurul element care depinde de lungimea de unda!
- Masurarea intensitatii este un spectru Fourier foarte simplu cu o componenta AC si un fond DC.
- Elementul rotativ este plasat direct in fata detectorului deci nu vor fi probleme cu deviatia radiatiei.
§ Principalele dezavantaje:
Pecizie mica atunci cand delta este 0°sau 180°
- Poate cauza probleme, de ex:masurarea unui unghi departe de unghiul Brewster pe un substrat transparent,etc.
Operatia AutoRetarderT:
§ Incorporat in instrumentul VASE.
§ Regleaza lumina de polarizare inaintea probei.
§ Sunt folosite mai multe pozitii ale AutoRetarder-ului pentru a obtine o precizie mai buna.
§ Masurarea parametrilor Y si D
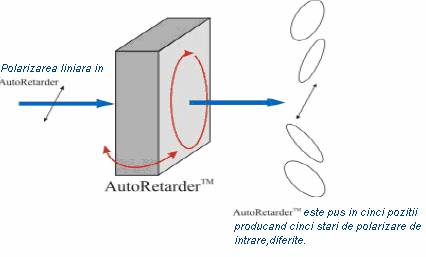
11
nm SiO2 pe Si: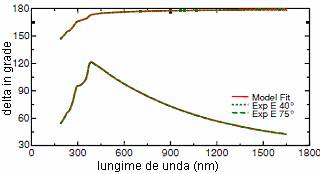
Compemsator rotativ
§Incorporarea tuturor elementelor JAWCO (cu exceptia lui VASE).
§ Precizie peste gama completa
- Psi = 0 la 90, Delta = 0 la 360
§ Minimalizeaza sensibilitatea polarizarii pentru detector si sursa.
§ Nu este necesar semnal DC pentru masurarea lui Psi si Delta.
- Semnalul DC permite masurarea depolarizarii.

Pana de curand lipsa componentelor rotative spectroscopice a impiedicat aceasta tehnologie sa se dezvolte mai mult.
Interactia luminii cu materialele
§ Reflectia: Ф0= Фr
§ Reflectia (Legea lui Snell): n0sin Ф0=n1sin Ф1

Coeficientii Fresnel
§ Descrie interfata reflectiei vs. unghiul incident.
-pentru lumina polarizata p- si s-
§ Raportul amplitudini undelelor de iesire si a celor de intrare
§ Reflectia creste odata cu cresterea indicilor.





Interactia luminii cu o pelicula fina
§ Reflectia /Transmisie se produce pe fiecare interfata.
§ Mai multe radiatii coerent combinate conduc la interfate destructiv/constructive.

Ce sunt constantele optice?
Descriu cum interactioneaza lumina cu materialele.
§ n = "indicele de refractie"
- Faza de viteze = c/n
- Directia de propagare (refractia)
§ k = "coeficientul de extinctie"
- energia undelor se pierde prin material
§ In
acelasi timp "indicele complex de refractie": ![]()
§
sau"Complexul dielectric":![]()
![]()
Relatia Kramers-Kronig
§ Partea reala si imaginara depin una de cealalta.

§ Absortia cauzeaza anomalii in dispersie.

Dispersia normala: Transparent
§ Indicele creste la lungimi de unda mici.
§ Indicile mai mare pentru absortie UV mai puternica.
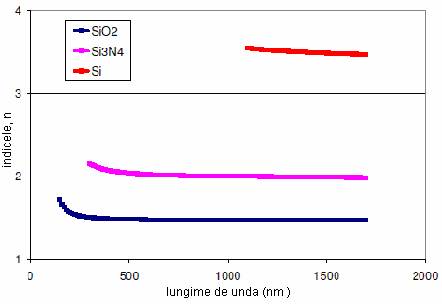
Anomalii in dispersie
§ Cand absortia creste , indicele va descreste odata cu descresterea lungimii de unda.Cand absortia descreste din nou, indicele va reveni la "normal".

Regiunea de absortie
§ Campul electric pierde energie la trecerea printr-un material.
- Tranzitie electrica
- Vibratie moleculara
- Vibratie de structura
- Purtator liber

Absortia in inflarosu
§ Vibratie moleculara:


§ Purtatori liberi (conductivitate):

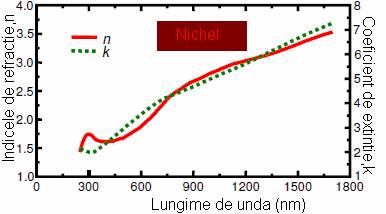
Tranzitie electronica
§ Electronii in banda de energie cu spatiu liber intre banda de valenta si banda de conductie.
§ Daca fotonul are energie mai mare decat spatiul liber,atunci electronul se poate excita pe o stare superioarea.

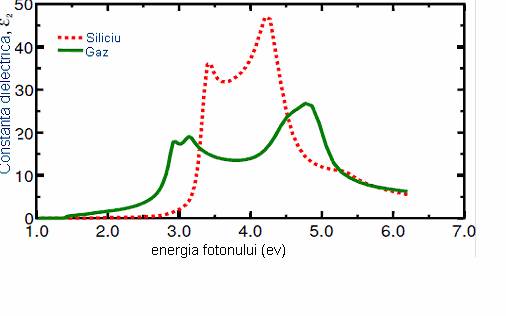
Mai mult de citit
1. R.M.A.Azzam, and N.M.Bashara, Ellipsometry and Polarized Light, North Holland Press, Amsterdam 1977, Second edition, 1987.
2. H.G.Tompkins, and W.A.McGahan, Spectroscopic Ellipsometry and Reflectometry, John Wiley & Sons, New York, 1999.
3. H.G.Tompkins and E.A.Irene (eds.) Handbook of Ellipsometry, William Andrew Publishing, New York, in press.
4. H. Fujiwara, Spectroscopic Ellipsometry Principles and Applications, John Wiley & Sons, New York, 2007.
International Conference on Spectroscopic Ellipsometry (Proceedings)
5. A.C.Boccara, C.Pickering, J.Rivory (eds.) Spectroscopic Ellipsometry, Elsevier Publishing, Amsterdam, 1993.
6. R.W.Collins, D.E.Aspnes, and E.A.Irene (eds.) "Proceedings from the Second International Conference on Spectroscopic ellipsometry" In: Thin Solid Films, vols. 313-314, 1998.
7. M.Fried, K.Hingerl, and J. Humlicek (eds.), "Proceedings from the Third International Conference on Spectroscopic ellipsometry". In: Thin Solid Films, vols. 455-456 , 2004.
8. "Proceedings from the Fourth International Conference on Spectroscopic ellipsometry", to be published.
Partea 2: Dare experimentale si aplicatii
Elipsometria este sensibila la:
§ Stratul de grosime
§ Constanta optice
§ Compozitie / Dotare
§ Rugozitatea suprafetei
§ Uniformitate
§ Anizotropia optica
§ Vibratie moleculara
§ Orice efect fizic care produce schimbari asupra proprietatilor optice ale materialului.
Datele elipsometrice vs. Proprietatile probei

Date experimentale ale spectroscopiei
§ Pentru cele mai multe probe o analiza analitica nu este posibilsa.
Folosind analiza modelului de baza de regresie:
- Calcularea raspunsului asteptat pentru model (date calculate)
- Comparam pentru a masura (date experimntale)
Diagrama datelor experimentale
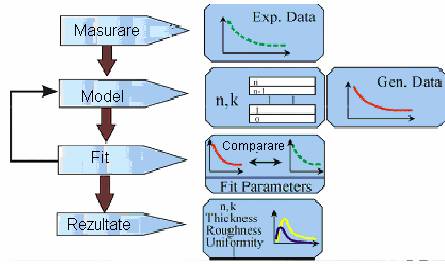
Construind un model optic
§ Presupunem o structura stratificata
- Grosimea fiecarui strat
- Constantele optice pentru fiecare strat
§ Software-ul de analizat foloseste ecuatii Fresnel,ecuatia interferentei peliculei subtiri,matrici algebrice, etc. Pentru a calcula date elipsometrice.

Comparand modelul gen. si datele experimentale
§ Metoda celor mai mici patrate cuantifica diferenta dintre datele eperimentale si datele calculate.

§ O mica eroare implica un fit mai bun.
Micsorand metoda celor mai mici patrate????
§ Definirea parametrilor "fit" si ajustarea lor pentru a minimaliza metoda celor mai mici patrate.
§ Algoritmul Marquardt-Levenberg* este utilizat in mod comun pentru regresie de rutina non-liniara.
§ Sunt importante valorile de la inceput.

* W.H. Press et al., Numerical Recipes in C, Cambridge, UK: Cambridge University Press, 1988
Inceperea masurarii valorilor
Preluarea de notiuni de baza
§ Generate de la model pentru a le compara cu date experientale.
§ Ajustarea parametrilor "fit" pentru a obtine valori de inceput cat mai bune.

Reguli generale pentru datele experimetale ale elipsometriei
§ Gasirea unei model simplu care sa se potriveasca cu datele experimentale.
poate fi subiectiv;aceasta este "arta datelor experimentale".
§ Verificarea modelului "fit" este unica.
§ Sunt fizice constantele optice si parametrii "fit"?
Trasaturi generale in datele SE
§ Daca este transparent se vad interfatele oscilatorii
§ Daca este absorbant arata ca niste substraturi
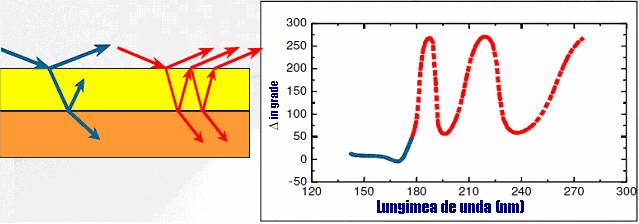
Grosimea peliculei transparente
§ Grosimea peliculei produce mai multe interferente oscilatorii.
§ In cele mai multe cazuri se poate determina simultan grosimea si constantele optice.

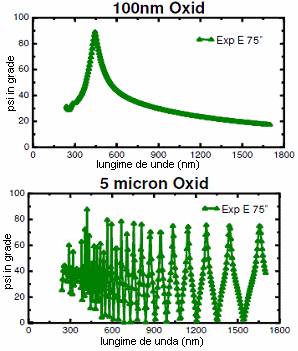
Plicula subtire
§ Nu se pot determina grosimea si constantele optice daca pelicula este prea subtire.
§ Grosimea minima a peliculei pentru a determina constantele optice si dependenta de grosime pentru sirurile spectrale, pentru dispersia materialelor si pentru complexitatea probei; caracteristic sirurilor este intre10-100Å.
Y-D Traiectoria (pentru o singura lungime de unda)

§ Elipsomteria "D" este inca foarte sensibil la grosimea peliculei.
§ Presupunem o valoare nominala a constantelor optice pentru a obtine grosimea peliculei.
§ Aplicatii: Gate Oxides,strat de protectie DLC , strat monomolecular, etc.
Model Gen. D (Oxid de Si subtire)??

Construirea unui model optic
§ Intoducem o structura nominala si o grosime pentru pelicula.
§ Constante optice specifice:
- Lista enumerata(fara variatie)
. In mod curent folosim valori de inceput.
- Amestecuri(variatie minima)
. EMA
- Aliaj de fisiere(variatie cunoscuta)
. Semiconductori compusi
- Legatura dispersiei (variatii constanse)
. Cauchy, modelul oscilatorului
- Wvl-by-Wvl Fit (variatie maxima)????
. Substraturi de absortie
SiO2 pe Si (constantele optice enumerate)

Pelicula transparenta
§ O legatura de dispersie ca si Cauchy poate fi folosita pentru a reduce numarul parametrilor "fit".

Pelicula dielectrica,folosind Cauchy
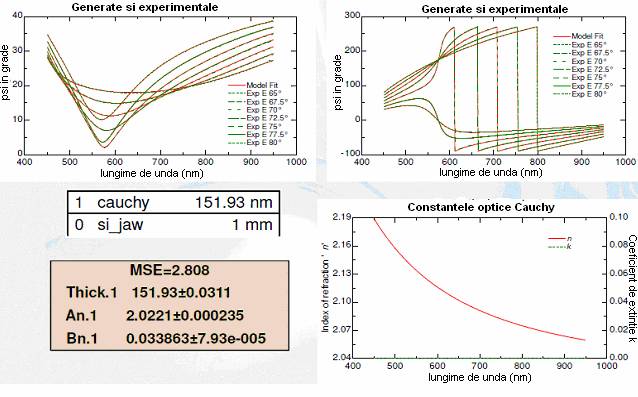
Multistart: 5-straturi Hi/Lo
§ Determinarea mai multor grosimi pentru "n" materiale de Hi si Lo.

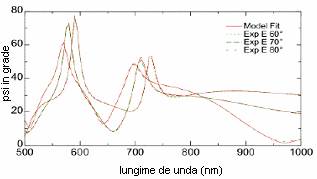
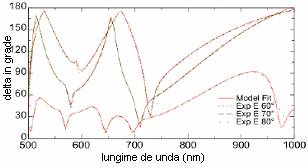
Exemplu de absortie a peliculei
§ Transparent pentru lungimi de unda mai mari: folosim Cauchy pentru a determina "n" si "t"
§ Absortie in UV: potrivim constantele optice pentru fiecare lungime de unda.
![]()



GenOsc Layer for Modeling Absorbing Films????
§ Folosim Wvl-by-Wvl pentru constantele optice ca valori de inceput.
§ Adaugam/potrivim orice combinatie de oscilatori.
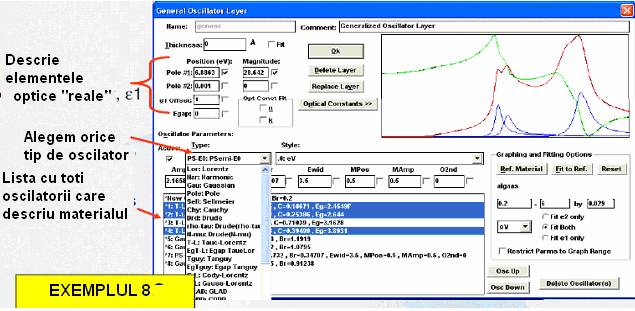
Pelicule metalice
§ Lumina trebuie sa patrunda pelicula pentru a determina grosimea.
§ Metalele de obicei sunt "opace" la 50-100nm.
§ Emisia de date (pe substratele de sticla) ofera informatii aditionale.
§ Oxidul gros poate spori sensibilitatea peliculei la metale.
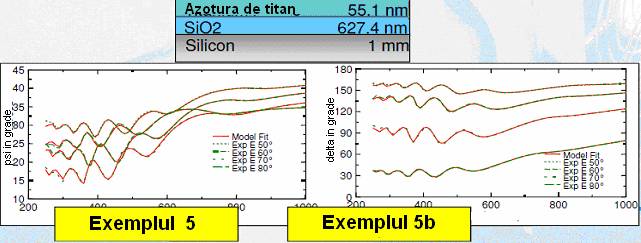
AlxGa1-xAs Multilayer???
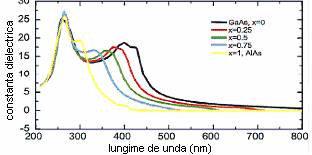

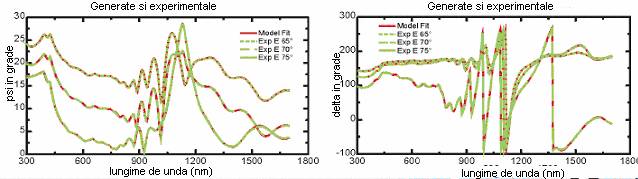
AME (Aproximatie medie efectiva)
§ Calcularea constantelor optice pentru materiale diferite.
§ Aplicatii:

Cristalinitate:polisilicon
§ Constantele optice depind de duritatea cristalinitatii, care la randul ei depinde de conditiile procesului.
§Nu putem potrivi AME pentru Si.
a-Si / SiO2 pe Silicon
§ Interfata dintre a-Si si SiO2 reduce metoda celor mai mici patrate la 6.

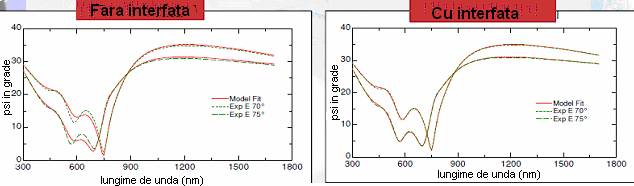
Index de notare
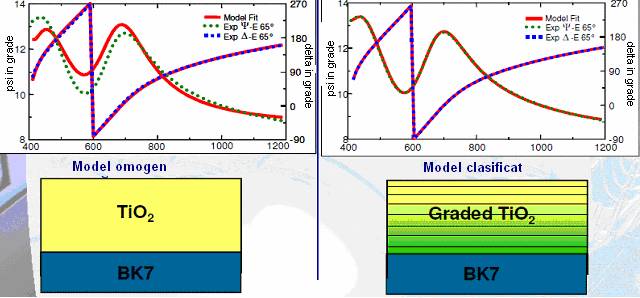
§ Impartim pelicula in "placi" in care variem indicele de la cea mai mica vloare la cea mai mare.
SiC Film with Index Grading????
§ MSE = 32 cu rugozitate; 11 cu classificare; 3 cu ambele.


Pelicula ITO, Modelul cu un singur strat omogen???
![]()
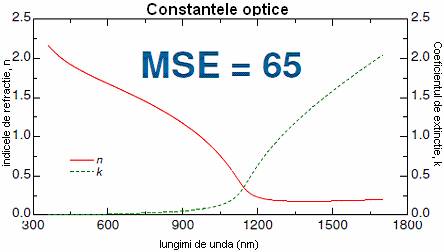

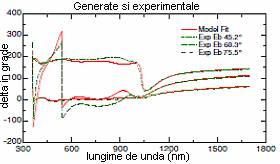
Grade liniare de la cea mai mica valoare la cea mai mare poate aduce MSE=55-60.
3-node Function-Based Grade for ITO???

MSE=6.6


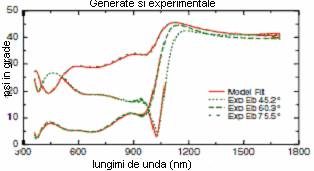
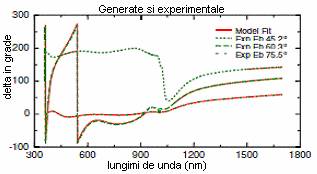
Reflectii incoerente din spate
§ Substraturi transparente:ne ocupam cu reflectii din spate.
- Inasprit in spate prin netezire.
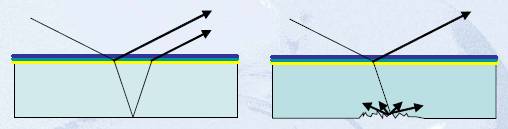
- Il includem in modelul optic
. Suportat de software-ul de analizat
. Cateodata aceasta reduce sensibilitatea spre varful peliculei.
. Exista posibilitatea sa nu se potriveasca datele asa cum substratele pot fi non-ideale(ex.,absortia.)
. Reflectia din spate este incoerenta, ceea ce conduce la depolarizare, ceea ce poate deasemenea fi masurata si analizata.
Pelicula de a-Si pe substratele de sticla
§ Reflectia din spate este inclusa in modelul optic.
§ Datele de depolarizare sunt incluse in analiza.


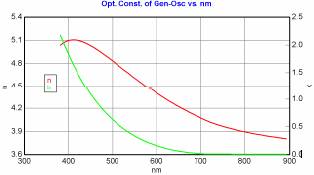

![]()
Testarea unicitatii parametrilor
§ Variem un parametru peste categoria specificata si potrivim ceilalti parametrii.
§ Evaluam forma of the MSE minimum???

Masuri traditionale ale elipsometriei
§ Presupunem nicio incrucisare a luminii polarizate p- cu lumina polarizata s- in proba, aceasta este o simpla diagonala Jones Matrix.


§Aceasa tine locul probelor izotropice care resping lumina.
Elipsometrie generalizata
§ Masuram elementele diagonale si non- diagonale pentru proba lui Jones Matrix:


4H SiC, In-Plan
§ Determinarea constantele optice de-a lungul ambelor directii ale cristalului.


STN Structura cristalului lichid
§ Fitarea include anizotropia (Dn), inclinare, rasucire.




Partea 2 - Sumar
§ Date de analiza folosite pentru a determina proprietatile materialului din datele masurate elipsometric.
§ Elipsometria este folosita in primul rand pentru a determina grosimea peiculei si constantele optice.
§ Elipsometria este deasemenea sensibbila la: rugozitate, regiuni interfaciale, compozitie,
Partea 3: Solutiile elipsometriei
§ Instrumente liniare si accesorii
§ Software-ul de pachete si capabilitati
6 Current Product Lines???
VASE: IR-VASE:
IR-VASE: RC2:
RC2: VUV-VASE:
VUV-VASE: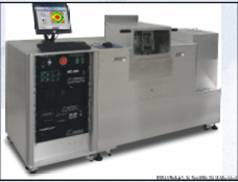
M-2000: alpha-SE:
alpha-SE:
VASE® Variable Angle Spectroscopic Ellipsometer???
CARACTERISTICI:
§ Elipsometru analizator rotativ brevetat de AutoRetarder T
§ Unghi automat : 20-90°
§ Categorie larga de lumgimi de unda: de la 190 la 2500 de nm.
§ Capabilitati flexibile de masurare
- Elipsometrie reflectata sau de transmisie, reflectie si transmitere (R/T), scatterometry???, elipsometrie generalizata si R/T, depolarizare si Muellermatrix???

AutoRetarderT
§ Ajustare automata pentru polarizarea de intrare pentru Acuratete mai mare si Masuratori avansate.

Proba interesanta : D intre 0 si 180°, cu indicele mic contrast intre pelicula si substrat.

Elipsometrie matricea Mueller
§ Masurarea anizotropiei si depolarizarii.
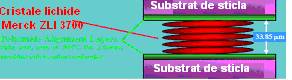
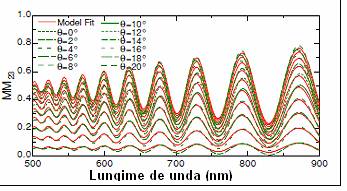

VUV-VASE®
§ De la 130nm la 1700nm
§ Analizator rotativ - AutoRetarderT
§ Curatat cu gaz uscat de azot
§ Unghi automat
§ Mapam pana la 300mm
§ Masuram lichidele cu celule de prisma???

Aplicatii litografice
§ Litografie la 248, 193 nm si 157nm.
q PhotoResists???
q BARC, TARC???
q Photomasks
q Pellicles
q Stepper Coatings
q Immersion Fluids


IR-VASE®
§ De la 1.7μm la 33μm
§ Compensator rotativ
§ Unghi automat
§ Optiuni pentru o caracterizare avansata:
- Cryostat (de la 4.2 la 700Kelvin)???
- Etapa de caldura
- Prisma/ATR Attachments???

Aplicatii in inflarosu
§ Multimea optica IR
§ Stratul de acoperire IR
§ Fotonii fizici
§ Efectele purtatorilor liberi
§ Vibratie moleculara
§ Anizotropia


SE + Lichide
§ Reflectie total atenuata


§ Deviatia minima a prismei


M-2000®
§ 193nm - 1700nm > 700 lungimi de unda simultan
§ Compensator rotativ cu detectie CCD???
§ Date precise si rapide pentru R&D si mapare uniforma
 mapare
mapare
§ Multe configuratii si optiuni
Categorie spectrala disponibila
Un sistem cu o sursa de lumina unica- aceeasi viteza nu comuta.
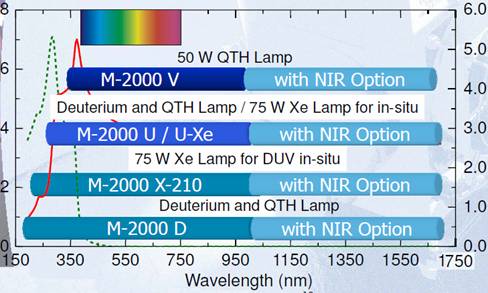
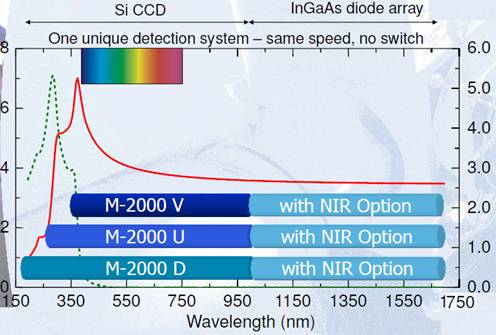
M-2000 - Several Ex-Situ Bases???
Horiz. Manual AOI???

Horiz. Automated AOI???

Baza verticala AOI
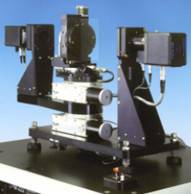
Horiz. Automated AOI with XY and Focus???

M-2000 MASE - Multi-Angle SE???
§ Masoara automat trei unghiuri +focalizare.

AccuMap-SE for Solar Modules???
§ Sticle largi modulate prin mapare 1.1m x 1.3m
§ Proba aproaape verticala
§ Proba fixata, , M-2000 ,zburand'
§ Sistem complet imprejmuit


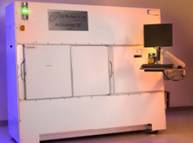
M-2000® In-situ
§ Viteza mare a datelor spectrului ne ofera timp real pentru controlul procesului!
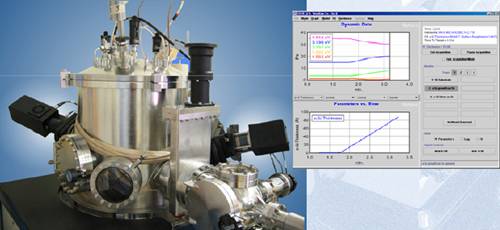
Elipsometria in pozitia initiala
§ Timp real
§ Istoria completa a probei
- Inainte, in timpul si dupa proces 0073
§ Masuratori directe pentru suprafete si interfete
§ Monitor si/sau controlul procesului
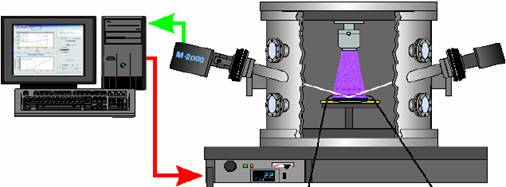
Integram : Efectele fereastra
§ Brevetat Window Corrections Enable Accurate
Data Acquisition through Standard UHV Windows???
![]()

Traseu #1: Si/Ta traseul depunerii
Traseu #1 (graficele se inpart in doua parti)

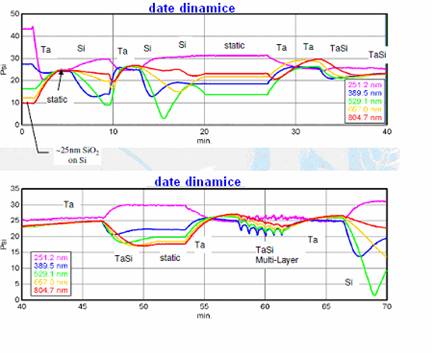
Traseu #3: Ta, Si & SiOx depunere
Traseu #3 (graficele se inpart in doua parti)


Traseu #4: Ta, TaOx & Ta2O5/SiO2multilayers???
Traseu #4 (graficele se inpart in doua parti)


"Interfata virtuala"(IV)
Conceptul "interfata virtuala" simplifica modelul optic din multiple straturi ale probei prin modelarea straturilor care stau la baza ca fiind un singur "pseudo substrat".
§ Un nou algoritm "Interfata Virtuala Generala" a fost dezvoltat pentru modele transparente de materiala asa cum sunt si dielectici.

Algoritmul controlului grosimii
§ potrivim untimele "n"valorii ale grosimiii intr-o linie dreapta.
§ extrapolam timpul pentru grosimea dorita
§ inchidem trapa la timpul prevazut(precizie de 1/20 de secunde)
§ permitem mare preciziei timpului chiar si la rate de achizitie mai mici
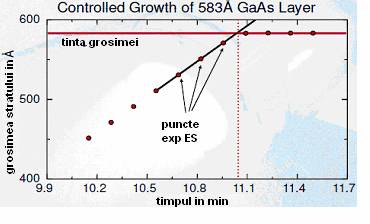
Mecanismul de directie al radiatiei brevetat "Prism-Assisted"
O noua apropiere pentru a instala fereastra SE pentru a exista in sistem
- camere de evaporare pentru e-radiatie
- camere CVD/PECVD
- camere corodate RIE/ECR
- camere MBE
- camere MOCVD
- camere de stropire

Provacarile integrari industriale
§ Deseori suprafete neprelucrate
- Foi de metal
- Risipeste o importanta parte din lumina
§ Substratele deseori sunt in miscare prin camera de depunare
- Roll-to-roll "web coating' processes???
§ Posibile vibratii
§ Opecatorii au putina spre deloc optica de fundal

M-2000RP for In-Line Web-Coating???

Coordonarea datelor din multiplul SE
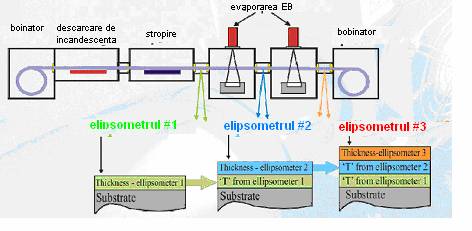
alfa-SET
§ Compensator rotativ
§ 380nm - 900nm
§ Usor de folosit!
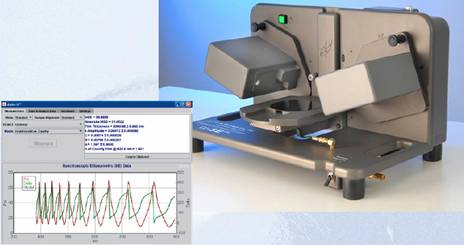
RC2T
§ Compensator dual de rotatie
- Un nou model acromatic compensator
§ >1000 lungimi de unda: de la UV la NIR
§ Masurari cu maricea Mueller pentru 16 elemente
§ Modular design for in situ and ex situ applications???

RC2 -SE generalizat
§ Anisotropic PEN (polyethylene naphthalate)???

RC2 - Matrice Mueller
§ MM pentru cristalele lichide rasucite nematic.

Accesorii
§
Mapare: 300mm:
Panel
plat: 
§ Criostat:

Etapa
de caldura:
§ Celule
lichide:
???Electrochem
Cell:
§ Deviatia
prismei: 
ATR:
SE cu temperatura variabila
§ categoria temperaturii: de la -80 la 500°C
§ Faza transmisiei in "Recordable Data Storage Media"???


Elipsometria si QCM-D
KSV
QCM
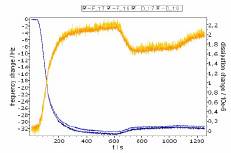


Q-Sense
QCM-D
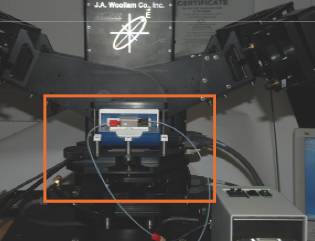
Celule solare - Textured Si Wafer???
M-2000X cu intensitatea optimizata
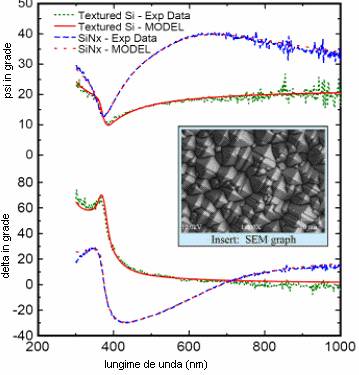


Selectam un sistem elipsometric
§ Categorie spectrala
§ Capacitatea unui unghi variabil
§ Viteza in masuratori
§ Precizia datelor
§ In pozitia originala, Mapare
§ Cheltueli
§ Trimite-ne proba!
Selectarea unei categorii spectrale
§ Include solicitare "Laser Wavelength"???
- Litografie
- Telecomunicatii
- Depozitarea datelor optice
§ Categorie spectrala vizibila
- Afisat de catre laptop
- Ochelari
§ Categorie transparenta pentru grosimea peliculei
Categorii spectrale sensibile pentru proprietatile materialului
§
Compozitia: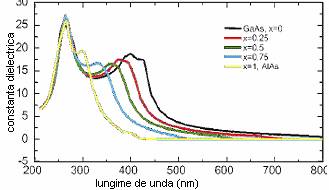
§
Cristalinitatea: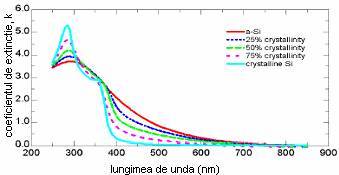
§
Conductivitatea: 
Capacitatea unui unghi variabil
§ Mai multe unghiuri cresc siguranta dar nu intotdeauna ne furnizeaza informatii noi si unice.
§ Mai multe unghiuri sunt folosiitoare pentru:
- Straturi groase si structuri complexe
- Pelicule anizotropice
- Alegem - 3 unghiuri sub,in apropierea si deasupra unghiului Brewster
Produse Software
§ WVASE32T
- Puternica, analiza generala capabila pentru elipsometrie si date optice
- Folosite pentru a dobandi date elipsometrice in ambele cazuri(in pozitia originala si in cealalta pozitie)
- Poate comunica cu alte software cum sunt link-urile DDE si TCO/IP
§ Maneger-ul VASE
- Foloseste software-uri "prietenoase" pentru masuratorile automate pentru VASE
§ Complet EASET
- Pentru sisteme cu mai multe lungimi de unda (M-2000, alfa-SE, RC2)
- Subsetul lui WVASE32 are capabiitatea de a analiza
- In pozitia originala masuratorile SE, timp real in procesare
- Un model mai usor si o reteta de generare a aplicatiei de mapare
- O usoara analizare a datelor si capabilitati de raportare
WVASE32T
§ Optiuni de modelare:
- Peste 300 de fisiere de material
- Peste 25 de modele de dispersie
- Aproximatie efectiva medie
- Clasificare in compozitie
- Straturi groase neuniforme
- Superlattice structures???
- Straturi model
- Materiale anizotropice
- Multe probe pentru analiza
- Mai multe tipuri de date

Combinam diferite relatii ale oscilatorului in acelasi strat cu interactia "dragand- drop"
Sellmeier, Drude, Lorentz, Harmonic, Gaussian, Tauc-Lorentz, Ionic, TOLO phonon, Tanguy.
Manager VASE
§ Orice date de achizitie si proceduri de analiza WVASE pot fi implementate in VMan pentru simpitatea "apasa butonul"

Rezultatele maanager-ului VASE
§ Vizualizarea convenabila a rezultatelor cu rapoarte si grafice toate la simpla atingere a butonului


Complet EASET
§ Interfatele cu tab ofera o usoara schimbare intre masuratori si moduri de analiza
§ File obisnuite pentru accesorii (temperatura de celule)
§ Grafice interactive
§ Scris in Java (poate rula pe Linux & Mac)

§ Elipsometria spectroscopica este o tehnica puternica pentru caracterizarea peliculelor subtiri.
§ J.A. Woollam Co. Ofera o categorie larga de produse pentru a intalni nevoile diverselor aplicatii ale elipsometriei spectroscopice.

|
Politica de confidentialitate |
| Copyright ©
2024 - Toate drepturile rezervate. Toate documentele au caracter informativ cu scop educational. |
Personaje din literatura |
| Baltagul caracterizarea personajelor |
| Caracterizare Alexandru Lapusneanul |
| Caracterizarea lui Gavilescu |
| Caracterizarea personajelor negative din basmul |
Tehnica si mecanica |
| Cuplaje - definitii. notatii. exemple. repere istorice. |
| Actionare macara |
| Reprezentarea si cotarea filetelor |
Geografie |
| Turismul pe terra |
| Vulcanii Și mediul |
| Padurile pe terra si industrializarea lemnului |
| Termeni si conditii |
| Contact |
| Creeaza si tu |